详情
混装BGA焊点开裂不良失效分析
文章出处:混装BGA焊点开裂不良失效分析_失效分析案例_典型案例_苏州天标检测技术有限公司 发布时间:2018-08-17
针对某混装工艺的PCBA上BGA器件发生功能不良,本案例通过CT扫描、切片分析初步确定造成器件功能不良的原因主要为BGA焊点开裂。
1. 案例背景
送检样品为某款PCBA板,上面BGA封装的CPU发生功能失效,初步怀疑为焊接问题导致。该BGA焊点使用锡膏为有铅锡膏,BGA值球为无铅,PCB焊盘为ENIG工艺。
2. 分析方法简述
通过对器件焊点进行切片分析,如图2所示,BGA焊点在焊盘端和器件端均存在开裂现象,但大部分焊点开裂主要发生在器件端界面。
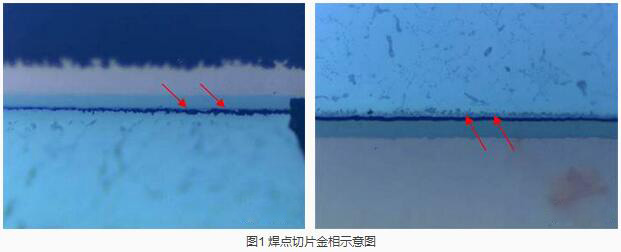

3. 结果与讨论
由上述测试分析可知,导致失效样品失效的直接原因为CPU上四周焊点发生开裂,而焊点开裂的原因与两方面相关:(1)焊点上界面存在较多Pb偏析和锡金合金,致使界面机械性能弱化;(2)部分焊点下界面存在富P层偏厚现象,致使界面机械性能弱化(3)样品在后续装配过程中,受较大机械应力。
混装工艺中,由于为无铅和有铅焊料混合封装,Pb偏析和界面的锡金合金在中不可避免,可通过焊接工艺曲线的控制来减少Pb偏析,界面的锡金合金过多与芯片端焊盘的金层过厚相关,后续可重点减小装配时的机械应力,并适当的优化工艺曲线来避免失效的发生。
上一个:
电感的失效分析
下一个:
无卤PCB板可靠度与故障分析
上一个:
电感的失效分析
下一个:
无卤PCB板可靠度与故障分析
搜索





